Slik bruker du GaN-felteffekttransistorer for effektive ikke-lineære strømkonstruksjoner med høyere spenning
Bidrag fra DigiKeys nordamerikanske redaktører
2023-01-26
Strømvirkningsgraden er en prioritet for elektroniske systemer i møte med både samfunnsmessige og regulatoriske krav. Strømomformingsvirkningsgrad og effekttetthet er avgjørende for konstruksjoners suksess, spesielt for konstruksjoner som spenner fra elektriske kjøretøy (EV) til høyspent kommunikasjon og industriell infrastruktur.
For å oppfylle disse kravene, må konstruktører av ikke-lineære strømsystemer skifte fra å bruke klassiske silisiumbaserte (Si) felteffekttransistorer av metalloksid (MOSFET-er) og bipolare transistorer med isolert port (IGBT-er), siden disse raskt er i ferd med å nå sine teoretiske grenser.
I stedet må konstruktører vurdere enheter som er basert på WBG-materialer (WBG – wide-bandgap – bred båndavstand), slik som galliumnitrid (GaN). GaN-enheter veksler raskere enn Si-enheter, håndterer høyere spennings- og effektnivåer, har mye mindre størrelse for et gitt effektnivå og fungerer med mye høyere virkningsgrad.
Denne artikkelen vil se nærmere på grunnleggende informasjon om GaN-FET-er, vise fordelene til disse sammenlignet med tradisjonelle Si-enheter i ikke-lineære strømkretser, introdusere eksempler fra Nexperia og ta for seg bruksområdene til disse.
Grunnleggende om GaN-FET-er
De grunnleggende elementene i strømomformingskretser er høyspente halvlederbrytere. Konstruktører har vært fokusert på å forbedre ytelsen til disse enhetene ved å gjøre følgende: Redusere konduksjonstap ved å redusere seriemotstand, redusere vekslingstap ved å øke overgangshastighetene og redusere parasittvirkninger. Disse konstruksjonsinnsatsene har generelt sett vært vellykkede for MOSFET-er og IGBT-er av silisium, men forbedringen har blitt langsommere etter hvert som driften av disse enhetene har nådd de teoretiske grensene.
Som et resultat har vi i løpet av de siste årene sett introduksjonen av WBG-enheter som bruker silisiumkarbid (SiC) og GaN, og disse har nå nådd volumproduksjon. Disse enhetene tilbyr høyere driftsspenningsområder, raskere vekslingstider og høyere virkningsgrad.
Båndavstanden i en halvleder er den minimale energien som kreves for å eksitere elektroner slik at de frigjøres fra deres bundne tilstand til en fri tilstand, slik at de kan lede elektrisitet (tabell 1).
|
Tabell 1: En oppsummering av de viktigste egenskapene som skiller halvledere med bred båndavstand – for eksempel GaN og SiC – fra Si. (Tabellkilde: Art Pini)
Enheter laget av halvledere med bred båndavstand kan fungere ved mye høyere spenninger, frekvenser og temperaturer sammenlignet med konvensjonelle halvledermaterialer som Si. Den bredere båndavstanden er spesielt viktig for å gi enheter muligheten til å operere ved mye høyere temperaturer. Den høye temperaturtoleransen betyr at disse enhetene, under normale forhold, kan fungere ved mye høyere effektnivåer. WBG-halvledere med et høyere kritisk elektrisk felt og høyere mobilitet, har den laveste ledemotstanden (RDS(ON)) for drain-source, noe som reduserer konduksjonstap.
De fleste materialer med høy båndavstand har også høye frielektronhastigheter, noe som gjør at de kan fungere med høyere vekslingshastigheter.
Sammenlignet med Si, som har en båndavstand på 1,12 elektronvolt (eV), er GaN og SiC sammensatte halvledere med en båndavstand som er rundt tre ganger høyere, henholdsvis 3,4 eV og 3,3 eV. Dette betyr at begge kan støtte høyere spenninger og høyere frekvenser.
Den høyere elektronmobilitet til GaN gjør disse mye bedre egnet for høyytelses, høyfrekvente konstruksjoner. De raskere vekslingshastighetene og høyere driftsfrekvensene som muliggjøres av GaN effekt-FET-ene, resulterer i forbedret signalstyring, passive filterkonstruksjoner med høyere grensefrekvenser og lavere rippelstrømmer. Dette muliggjør bruk av mindre induktorer, kondensatorer og transformatorer, noe som resulterer i redusert total størrelse og vekt.
GaN-FET-er kalles høyelektronmobilitetstransistorer (HEMT). Den høye elektronmobilitet er en funksjon av FET-strukturen (figur 1).
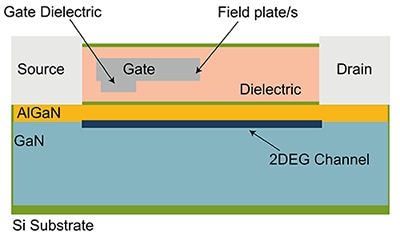 Figur 1: Tverrsnittvisning av en GaN-FET basert på et Si-substrat. (Bildekilde: Nexperia)
Figur 1: Tverrsnittvisning av en GaN-FET basert på et Si-substrat. (Bildekilde: Nexperia)
GaN-FET-er bruker eksisterende produksjonsanlegg for silisium-CMOS-er, noe som gjør dem kostnadseffektive å produsere. Et GaN-lag dannes på Si-substratet ved å avsette et kimlag (seed layer) og et gradert lag med GaN og aluminiumgalliumnitrid (AlGaN) som isolasjonslag (ikke vist i den grafiske fremstillingen) før det rene GaN-laget vokser. Et andre AlGaN-lag avsettes på GaN-laget. Dette oppretter en piezoelektrisk polarisasjon, med et overskudd av elektroner som genereres umiddelbart under AlGaN-laget, som er en svært ledende kanal. Dette overskuddet av elektroner er kjent som en todimensjonal elektrongass (2DEG). Navnet gjenspeiler den svært høye elektronmobiliteten i dette laget.
Et utladingsområde dannes under gaten. Driften av gaten er lik en N-kanal effekt-MOSFET av silisium i forsterkningsmodus. En positiv spenning påført gaten på denne enheten, slår den på.
Denne strukturen gjentas flere ganger for å danne en effekthalvleder. Sluttresultatet er en prinsipielt enkel, elegant og kostnadseffektiv løsning for strømveksling.
For å oppnå en enhet med høyere spenning, økes avstanden mellom «drain» og «gate». Ettersom resistiviteten til GaN 2DEG er svært lav, er virkningen på motstanden av å øke sperrespenningskapasiteten mye lavere sammenlignet med silisiumenheter.
GaN-FET-er kan konstrueres slik at de fungerer i en av to konfigurasjoner, forsterkningsmodus eller utarmingsmodus. FET-er i forsterkningsmodus er normalt av, så en positiv spenning relativt til drain/source må påføres gaten for å slå på FET-en. FET-er i utarmingsmodus er normalt på, så en negativ gate-spenning relativt til drain/source må påføres for å slå av FET-en. FET-er i utarmingsmodus er problematisk i et strømsystem, fordi en negativ forspenning må påføres GaN-FET-er i utarmingsmodus før systemet slås på.
En måte å omgå dette problemet på, er å kombinere en lavspent silisium-FET med en GaN-FET i utarmingsmodus i kaskodekretskonfigurasjon (figur 2).
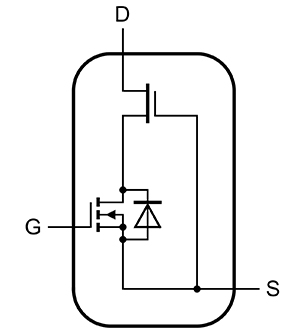 Figur 2: En lavspent silisium-MOSFET i kaskadekonfigurasjon med en GaN-FET i utarmingsmodus, resulterer i robustheten til Si-gatestrukturen med de forbedrede høyspente klokkeegenskapene til GaN-enheten, og har i tillegg –når det gjelder GaN-FET-en i utarmingsmodus – den sammensatte enheten avslått ved oppstart. (Bildekilde: Nexperia)
Figur 2: En lavspent silisium-MOSFET i kaskadekonfigurasjon med en GaN-FET i utarmingsmodus, resulterer i robustheten til Si-gatestrukturen med de forbedrede høyspente klokkeegenskapene til GaN-enheten, og har i tillegg –når det gjelder GaN-FET-en i utarmingsmodus – den sammensatte enheten avslått ved oppstart. (Bildekilde: Nexperia)
Kaskodekretsen bruker Si MOSFET-gatestrukturen som har fordelen av å ha høyere grenser for gatedrift som er samsvart med eksisterende MOSFET-gatedriver-IC-er, og GaN-FET-en i utarmingsmodus er av ved oppstart.
En av de viktigste funksjonene til GaN-FET-er, er den høye virkningsgraden. Dette skyldes: Lav seriemotstand, som reduserer konduksjonstapene; de raskere vekslingstidene, som senker vekslingstapene; og den lavere sperreforsinkelsesladningen, som er ansvarlig for de lave sperreforsinkelsestapene.
Ved å bruke en topologi med en opptransformeringsomformer i halvbro, er det mulig å sammenligne virkningsgraden til GaN-FET-er og Si MOSFET-er (figur 3).
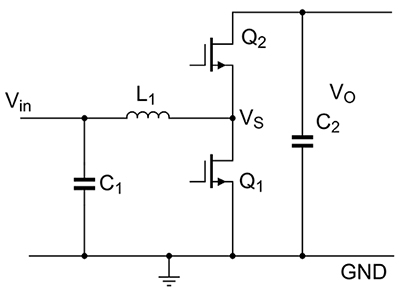 Figur 3: Her vises skjemaet over en opptransformeringsomformer i halvbro som brukes til å sammenligne virkningsgraden til MOSFET-er og GaN-FET-er ved å bytte transistorene Q1 og Q2 med hver type. (Bildekilde: Nexperia)
Figur 3: Her vises skjemaet over en opptransformeringsomformer i halvbro som brukes til å sammenligne virkningsgraden til MOSFET-er og GaN-FET-er ved å bytte transistorene Q1 og Q2 med hver type. (Bildekilde: Nexperia)
Opptransformeringsomformeren har en inngangsspenning på 240 volt, utgangen er 400 volt og vekslingsfrekvensen er 100 kilohertz (kHz). Virkningsgraden og tapene sammenlignes over et effektområde på opptil 3500 watt (figur 4).
 Figur 4: En sammenligning av virkningsgraden og effekttapet mellom GaN-FET-er og MOSFET-er i en identisk krets, som viser fordelene til GaN-FET-er. (Bildekilde: Nexperia)
Figur 4: En sammenligning av virkningsgraden og effekttapet mellom GaN-FET-er og MOSFET-er i en identisk krets, som viser fordelene til GaN-FET-er. (Bildekilde: Nexperia)
GaN-FET-er opererer med omtrent 20 % høyere virkningsgrad sammenlignet med MOSFET-er, og effekttapet er lavere med en faktor på omtrent tre. Ved 2000 watt er tapet i MOSFET-er ca 62 watt; i GaN-FET-er er tapet kun 19 watt. Dette betyr at kjølesystemet kan være mindre, noe som forbedrer den volumetriske virkningsgraden til opptransformeringsomformeren.
Mindre åpenbart er at målingen ble utført ved nesten 3500 watt for GaN-FET-en på grunn av den høyere maksimale spenningsgrensen. GaN-FET-en har derfor en klar fordel.
Komme i gang med GaN for høyere spenninger
For konstruksjoner med høyere spenning, tilbyr Nexperia to 650-volts GaN-FET-er, GAN063-650WSAQ og GAN041-650WSBQ. Begge er N-kanal FET-er som normalt er slått av. GAN063-650WSAQ er klassifisert for å håndtere en maksimal drain-til-source-spenning på 650 volt, og den kan opprettholde en forbigående (transient) puls (med en pulsbredde på mindre enn ett mikrosekund) på 800 volt. Den er klassifisert for en drain-strøm på 34,5 ampere (A) og et effekttap på 143 watt ved 25 °C. Ledemotstanden for drain-til-source er vanligvis 50 milliohm (mΩ), med en maksimumsgrense på 60 mΩ.
GAN041-650WSBQ har samme maksimale spenning på 650 volt fra drain til source med samme transientgrense på 800 volt. Den er forskjellig ved at den kan håndtere en maksimal drain-strøm på 47,2 A og et maksimalt effekttap på 187 watt ved romtemperatur. Den vanlige kanalmotstanden er 35 mΩ, maksimalt 41 mΩ.
En Nexperia-referansekonstruksjon som bruker GAN063-650WSAQ i halvbrokonfigurasjon, er vist i figur 5.
 Figur 5: En anbefalt konstruksjon for et effekttrinn med halvbro ved å bruke GAN063-650WSA GaN-FET-er. Skjemaet viser bare FET-driveren og halvbroens utgangstrinn, samt relaterte komponenter. (Bildekilde: Nexperia)
Figur 5: En anbefalt konstruksjon for et effekttrinn med halvbro ved å bruke GAN063-650WSA GaN-FET-er. Skjemaet viser bare FET-driveren og halvbroens utgangstrinn, samt relaterte komponenter. (Bildekilde: Nexperia)
Skjemaet viser Si8230, en høy/lav dobbel isolert gate-driver, som brukes til å drive gatene til GaN-FET-er. Utgangen fra gate-driveren er koblet til gaten via en 30 Ω gate-motstand, noe som er nødvendig for alle GaN-enheter. Gate-motstanden styrer ladetiden til gate-kapasitansen, noe som påvirker ytelsen til den dynamiske vekslingen. R-C-nettverkene mellom drain og source til FET-ene hjelper også til med å styre vekslingsytelsen. Gate-driver-nivåene for GaN-FET-en er mellom 0 og 10 til 12 volt.
Den høye vekslingshastigheten til GaN-FET-ene (vanligvis rundt 10 til 11 nanosekunder (ns)) krever nøye utforming for å minimere parasittinduktans, og bruken av RC-dempere for å dempe ringing på grunn av spennings- og strømtransienter. Det er flere RC-dempere (R17 til 19 og C33 til 35) i konstruksjonen mellom den høyspente strømforsyningen og jord. Demperne reduserer ringing forårsaket av interaksjonen mellom GaN-FET-en og forbikoblingsnettverket. Dempere bør kobles til så nær drain på høyside-FET-en som mulig. De er implementert med overflatemonterte motstander og keramiske kondensatorer med lav effektiv seriemotstand (ESR) for å minimere lederinduktans.
Komponentnettverket dannet av R4, D1, C12 og C13 er en bootstrap-strømforsyning for høyside-gate-driveren. D1 bør være en hurtig lavkapasitansdiode fordi sperreskiktkapasiteten bidrar til vekslingstap. R4 begrenser innkoblingsladestrømmen; en verdi i området fra 10 til 15 Ω fungerer godt.
Konklusjon
Behovet for høyere virkningsgrad innen effektomforming og effekttetthet, for alt fra elbiler til kommunikasjon og industriell infrastruktur, krever et skifte fra klassiske Si-strukturer. Som vist, gir GaN-FET-er en vei fremover for neste generasjon av konstruksjoner, ved å tilby høyere driftsspenninger, raskere vekslingstider og høyere virkningsgrad. Hyllevarekomponenter, som i noen tilfeller støttes av referansekonstruksjoner, hjelper konstruktører med å komme raskt i gang med prosjekter.

Disclaimer: The opinions, beliefs, and viewpoints expressed by the various authors and/or forum participants on this website do not necessarily reflect the opinions, beliefs, and viewpoints of DigiKey or official policies of DigiKey.