Slik bruker du tredjegenerasjons SiC MOSFET-er i strømkonstruksjoner for høyere ytelse og effektivitet
Bidrag fra DigiKeys nordamerikanske redaktører
2022-11-02
Det er en ubønnhørlig drivkraft mot høyere effektivitet, mindre størrelse og forbedret ytelse på tvers av strømkonstruksjoner, for eksempel industrielle motordrivere, AC-DC- og DC-DC-invertere/omformere, batteriladere og energilagringssystemer. Disse aggressive ytelseskravene har overgått egenskapene til MOSFET-er av silisium (Si) og innledet nyere transistorarkitekturer basert på silisiumkarbid (SiC).
Selv om disse nyere enhetene kunne tilby betydelige fordeler på tvers av viktige ytelsesmålinger, var det klokt av konstruktører å være skeptiske til førstegenerasjons silisiumkarbidenheter på grunn av diverse begrensninger og konstruksjonsusikkerheter. Andregenerasjons enheter kom med forbedrede spesifikasjoner, samt en bedre forståelse av enhetens nyanserikdom. Etter hvert som ytelsen til SiC MOSFET-er økte og tiden det tok å få det ferdige produktet ut på markedet ble mer intens, brukte konstruktører disse nyere enhetene til å oppfylle produktmålene. I nyere tid demonstrerer tredjegenerasjons enheter modenheten til silisiumkarbidbaserte (SiC-baserte) strømenheter. Disse enhetene gir brukere forbedringer på tvers av viktige parametere, samtidig som de bygger på tidligere generasjoners konstruksjonserfaring og relatert ekspertise.
Denne artikkelen sammenligner silisium (Si) med silisiumkarbid (SiC), og går videre til å ta for seg utviklingen og overgangen til tredjegenerasjons SiC MOSFET-er. Den introduserer deretter eksempler fra den virkelige verden fra Toshiba Semiconductor and Storage Corp. (Toshiba) for å vise hvordan disse enhetene kan hjelpe konstruktører oppnå betydelige fremskritt innen strømsystemkonstruksjon.
Silisium (Si) kontra silisiumkarbid (SiC)
I løpet av de siste tiårene har SiC MOSFET-er transformert konstruksjonen av strømsystemer, som spenner fra grunnleggende strømforsyninger og omformere til motordrivere. I likhet med den topolede transistoren med isolert port (IGBT – insulated gate bipolar transistor) – en funksjonsmessig lik halvleder, men med svært forskjellig konstruksjon og egenskaper – har Si MOSFET-en med optimalisert veksling muliggjort en overgang fra tradisjonell, ineffektiv strømomforming og -styring basert på lineære topologier, til en mye mer effektiv og kompakt tilnærming som bruker vekslet styring.
De fleste av disse konstruksjonene bruker en type pulsbreddemodulasjon (PWM) til å levere og opprettholde ønsket spenning, strøm eller effektverdi i en tilbakekoblingssammenstilling med lukket sløyfe. Etter hvert som bruken av MOSFET-er av silisium vokste, økte også kravene til dem. I tillegg har nye effektivitetsmål (mange basert på regulatoriske mandater), markedene for elektriske kjøretøy og smartere motorstyring, strømomforming for fornybar energi og tilknyttede energilagringssystemer, presset disse MOSFET-ene til å gjøre mer, på en bedre måte.
Som et resultat har en betydelig FoU-innsats forbedret ytelsen til silisiumbaserte MOSFET-er, men forskere innså at denne innsatsen var i ferd med å redusere avkastningen. Heldigvis hadde de et alternativ, i teorien, basert på strømvekslingsenheter som brukte silisiumkarbid (SiC) som substrat i stedet for kun silisium (Si).
Hvorfor bruke silisiumkarbid?
Silisiumkarbid har, av ulike grunner relatert til dyp-fysikk, tre elektriske hovedegenskaper som skiller seg betydelig fra kun silisium, og hver av disse tilbyr driftsmessige fordeler. Det er også andre, mer subtile forskjeller (figur 1).
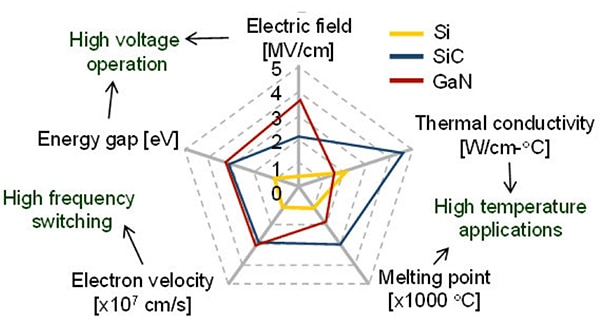 Figur 1: Omtrentlig sammenligning mellom viktige materialegenskaper for silisiumkarbid (SiC) kontra silisium (Si) og galliumnitrid (GaN). (Bildekilde: Researchgate)
Figur 1: Omtrentlig sammenligning mellom viktige materialegenskaper for silisiumkarbid (SiC) kontra silisium (Si) og galliumnitrid (GaN). (Bildekilde: Researchgate)
De tre hovedegenskapene er:
- Høyere kritisk nedbrytning av elektrisk feltspenning på omtrent 2,8 megavolt/centimeter (MV/cm) kontra 0,3 MV/cm, så drift ved en gitt nominell spenning er mulig med et mye tynnere lag, noe som i stor grad reduserer drain-kildens på-motstand (on-resistance) (RDS(on)).
- Høyere termisk konduktivitet, noe som muliggjør høyere strømtetthet i et tverrsnittsareal.
- Bredere båndavstand (energiforskjellen i elektronvolt mellom toppen av valensbåndet og bunnen av konduksjonsbåndet i halvledere og isolatorer), noe som resulterer i lavere lekkasjestrøm ved høye temperaturer. Derfor kalles ofte SiC-dioder og felteffekttransistorer (FET-er) for WBG-enheter (WBG – wide bandgap).
Som et resultat kan silisiumkarbidbaserte enheter blokkere spenninger som er opptil ti ganger høyere enn det konstruksjoner med kun silisium er i stand til. De kan også veksle omtrent ti ganger raskere, og de har en RDS(on) som er halvparten eller mindre, ved 25 °C, samtidig som de bruker det samme støpeområdet (alle omtrentlige tall, selvfølgelig). Dessuten er vekslingsrelaterte tap i silisiumkarbidenheter mindre, siden de ikke har noen skadelig halestrøm (tail current). Samtidig vil evnen deres til å fungere ved mye høyere temperaturer, cirka 200 °C kontra 125 °C, bidra til å forenkle problemer relatert til termisk konstruksjon og styring.
På grunn av ytelsesegenskapene og fremskrittene deres, har silisiumkarbidenheter nå tatt en fremtredende plass i «effekt kontra hastighet»-konstruksjonsmatrisen, og har derfor blitt en del av samme gruppe som IGBT-er, SiC MOSFET-er og GaN-enheter (figur 2).
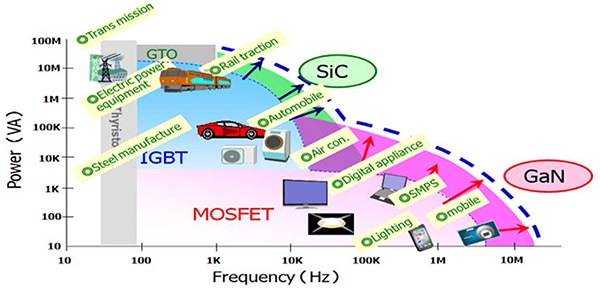 Figur 2: Ytelsesegenskapene til SiC MOSFET-er gjør dem egnet for et bredt spekter av konstruksjoner, som omfatter et spekter av strøm- og frekvensklassifiseringer. (Bildekilde: Toshiba)
Figur 2: Ytelsesegenskapene til SiC MOSFET-er gjør dem egnet for et bredt spekter av konstruksjoner, som omfatter et spekter av strøm- og frekvensklassifiseringer. (Bildekilde: Toshiba)
Veien fra den underliggende silisiumkarbid-materialvitenskapen og -enhetsfysikken til kommersielle silisiumkarbid-MOSFET-er var verken rask eller enkel (figur 3). Etter omfattende forsknings- og produksjonsinnsats, ble de første silisiumkarbidbaserte enhetene – Schottky – introdusert i 2001. I de neste to tiårene utviklet og lanserte bransjen produksjonsvolumer med første-, andre- og tredjegenerasjons MOSFET-er av silisiumkarbid. Hver generasjon tilbyr målrettede forbedringer i spesifikke parametere, i tillegg til noe forskjellige avveininger.
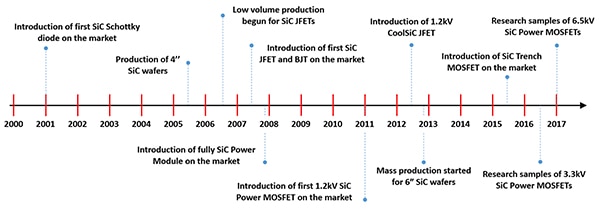 Figur 3: Historien til kommersielle silisiumkarbidbaserte enheter begynner med de første kommersielle Schottky-diodene av silisiumkarbid, som dukket opp i 2001. (Bildekilde: IEEE Transactions on Industrial Electronics, 2017)
Figur 3: Historien til kommersielle silisiumkarbidbaserte enheter begynner med de første kommersielle Schottky-diodene av silisiumkarbid, som dukket opp i 2001. (Bildekilde: IEEE Transactions on Industrial Electronics, 2017)
Vær oppmerksom på at det er viktig å tydeliggjøre terminologien – i likhet med Si-forgjengerne, er SiC FET-er også MOSFET-er. I vid forstand er deres interne fysiske strukturer like, og begge enhetene har tre terminaler: kilde, drain og gate. Forskjellen ligger i navnene deres: silisiumkarbidbaserte FET-er bruker silisiumkarbid (SiC) som basismateriale i stedet for kun silisium (Si).
Begynn med første og andre generasjon
Det er mange parametere som karakteriserer ytelsen til en vekslingsenhet. Noen av de mange statiske parametrene er den maksimale driftsspenningen og den maksimale strømmen, sammen med to kvalitetstall (FoM – figures of merit): RDS(on) og den maksimale driftstemperaturen, som er relatert til strømstyringsegenskapene for en gitt platestørrelse og -kapsling.
Som vekslingsinnretninger, er dynamiske parametere også svært viktige, ettersom de er nødvendige for å vurdere vekslingstap. Det mest siterte dynamiske kvalitetstallet, er produktet av RDS(on) og gate-ladningen RDS(on) × Qg, mens et stadig viktigere kvalitetstall er ladningen til sperreforsinkelsen, Qrr. Størrelsen og mulighetene til gate-driveren som trengs for å oppnå riktig kilde- og drain-strøm til vekslingsenheten – og oppnå dette uten overskridelse, dempet svingning eller andre forvrengninger – fastsettes hovedsakelig av disse kvalitetstallene.
Bruken og markedsveksten til førstegenerasjons silisiumkarbidenheter hadde blitt holdt tilbake på grunn av pålitelighetsproblemer. En av disse involverer PN-dioder, som er plassert mellom strømkilden og drain-terminalen til en effekt-MOSFET. Spenning som påføres PN-dioden strømsetter den, noe som resulterer i en endring i ON-motstand som forringer enhetens pålitelighet.
Toshibas andregenerasjons enhet modifiserte den grunnleggende silisiumkarbid-enhetsstrukturen ved å bruke en Schottky-diode (SBD – Schottky barrier diode) innebygd i MOSFET-en, noe som i stor grad løste dette problemet (figur 4). Dette forbedret påliteligheten med mer enn en størrelsesorden. Den nye strukturen forhindret strømsetting av PN-dioden ved å posisjonere SBD-en parallelt med PN-dioden inne i cellen. Strømmen flyter gjennom den innebygde SBD-en fordi spenningen dens i ON-tilstanden (påslått tilstand) er lavere enn den til PN-dioden, noe som dermed demper noen endringer i ON-motstand (motstand i påslått tilstand) og forringelse av MOSFET-ens pålitelighet.
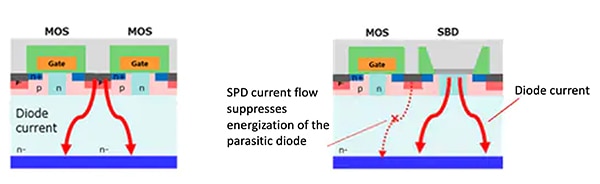 Figur 4: I motsetning til den typiske SiC MOSFET-en uten noen intern Schottky-diode (SBD) (venstre), kan versjonen med denne dioden (høyre) minimere strømtilførselen til den parasittiske PN-dioden. (Bildekilde: Toshiba)
Figur 4: I motsetning til den typiske SiC MOSFET-en uten noen intern Schottky-diode (SBD) (venstre), kan versjonen med denne dioden (høyre) minimere strømtilførselen til den parasittiske PN-dioden. (Bildekilde: Toshiba)
MOSFET-er med innebygde SBD-er var allerede i praktisk bruk, men bare i høyspenningsprodukter – for eksempel 3,3 kilovolt (kV) – ettersom de innebygde SBD-ene førte til at ON-motstanden til slutt steg til et nivå som bare høyspenningsprodukter kan tolerere. Toshiba justerte forskjellige enhetsparametere og fant ut at forholdet mellom SBD-området i en MOSFET er nøkkelen til å dempe den økte ON-motstanden. Ved å optimalisere SBD-forholdet, utarbeidet Toshiba en 1,2 kV-klasse av SiC MOSFET-er med en merkbar forbedring i pålitelighet.
Men, i likhet med mange forbedringer, var det også avveininger. Selv om den nye enhetsstrukturen forbedret påliteligheten betydelig, hadde den også en uheldig virkning på to kvalitetstall. Den økte nominell RDS(on) samt RDS(on) × Qg, noe som reduserte ytelsen til MOSFET-en. For å kompensere for og redusere ON-motstanden, hadde andregenerasjons SiC MOSFET-er økt plateområde (die area), men dette økte kostnadene.
Tredje generasjon viser sann modenhet
Som en anerkjennelse av denne bekymringen utviklet Toshiba en tredje generasjon av SiC MOSFET-enheter, kalt TWXXXN65C/TWXXXN120C-familien. Disse enhetene optimaliserte strukturen til det strømspredende laget for å redusere cellestørrelsen og også levere høyere spenning, raskere veksling og lavere ON-motstand.
ON-motstanden reduseres delvis ved å redusere spredningsmotstanden (Rspread). SBD-strømmen økes ved å innsprøyte nitrogen i bunnen på det brede P-type-diffusjonsområdet (P-well) til SiC MOSFET-en. Toshiba reduserte også JFET-regionen og innsprøytet nitrogen for å redusere tilbakekoblingskapasitans og JFET-motstand. Som et resultat ble tilbakekoblingskapasitansen redusert uten å øke på-motstanden. Stabil drift uten svingninger i ON-motstand ble også oppnådd ved hjelp av optimalisert posisjonering av SBD-en.
For øyeblikket består familien av SiC MOSFET-er på 650 volt og 1200 volt som er konstruert for industrielle bruksområder med høy effekt, for eksempel 400-volts og 800-volts AC-DC-strømforsyninger, solcelleomformere (PV) og toveis DC-DC-omformere for avbruddsfrie strømforsyninger (UPS). Både de 650-volts og 1200-volts SiC MOSFET-ene tilbys i TO-247-kapslinger med tre ledere, som er standard for bransjen (figur 5).
 Figur 5: Toshiba 650-volts og 1200-volts tredjegenerasjons SiC MOSFET-er er innkapslet i en standard T0-247-kapsling, og de er godt egnet for et bredt spekter av strømomformings-, kontroll- og styringskonstruksjoner. (Bildekilde: Toshiba)
Figur 5: Toshiba 650-volts og 1200-volts tredjegenerasjons SiC MOSFET-er er innkapslet i en standard T0-247-kapsling, og de er godt egnet for et bredt spekter av strømomformings-, kontroll- og styringskonstruksjoner. (Bildekilde: Toshiba)
RDS(on) × Qg-kvalitetstallene reduseres i disse tredjegenerasjons SiC MOSFET-ene med 80 % sammenlignet med Toshibas andregenerasjons enheter – et betydelig fall – mens vekslingstap reduseres med omtrent 20 %. Den innebygde Schottky-diodeteknologien tilbyr også ultralav diodespenning (VF).
Det er andre konstruksjonsdistinksjoner knyttet til MOSFET-er. Ta for eksempel VGSS. VGSS er den maksimale spenningen som kan påføres mellom gate- og kilde-terminalene, mens drain- og kilde-terminalene er kortsluttet. For tredjegenerasjons silisiumkarbidenheter, er VGSS-området fra 10 til 25 volt, der 18 volt er den anbefalte verdien. De brede VGSS-klassifiseringene bidrar til å forenkle konstruksjonen og samtidig forbedre påliteligheten.
Videre bidrar den lave motstanden og en høyere gate-terskelspenning (VGS(th)) – spenningen hvor MOSFET-kanalen begynner å lede – til å forhindre funksjonsfeil, slik som utilsiktet påslåing på grunn av spenningsspisser, forstyrrelser og oversvingninger. Denne spenningen varierer fra 3,0 til 5,0 volt, noe som bidrar til å sikre forutsigbar vekslingsytelse med minimal vandring, samtidig som enkel gate-driverkonstruksjon muliggjøres.
En nærmere titt på 650-volts og 1200-volts tredjegenerasjons SiC MOSFET-er
En titt på de 650-volts og 1200-volts enhetene, som er to enheter i hver sin ende av familiespekteret, viser spennet av evnene deres. Den fysiske kapslingen, uttakspinnene og det skjematiske symbolet er like for dem alle (figur 6), men spesifikasjonene er forskjellige.
 Figur 6: Alle medlemmer av Toshibas tredjegenerasjons SiC MOSFET-familie har den samme fysiske sammenstillingen og det samme skjematiske symbolet. Legg merke til den integrerte Schottky-dioden (SBD) i symbolet. (Bildekilde: Toshiba)
Figur 6: Alle medlemmer av Toshibas tredjegenerasjons SiC MOSFET-familie har den samme fysiske sammenstillingen og det samme skjematiske symbolet. Legg merke til den integrerte Schottky-dioden (SBD) i symbolet. (Bildekilde: Toshiba)
TW015N65C er en 650-volts N-kanal-enhet klassifisert til 100 ampere (A) og 342 watt. De typiske spesifikasjonsverdiene for enheten er en inngangskapasitans (CISS) på 4850 pikofarad (pF), en lav gate-inngangsladning (Qg) på 128 nanocoulomb (nC) og en nominell RDS(on) på bare 15 milliohm (mΩ).
I tillegg til tabeller med minimumstall, typiske tall og maksimumstall for statiske og dynamiske parametere, har databladet grafer som viser ytelsen til kritiske parametere i forhold til faktorer som temperatur, drain-strøm og gate-kildespenning (VGS). For eksempel er verdien av RDS(on) i forhold til temperatur, drain-strøm (ID) og gate-spenning VGS vist i figur 7.
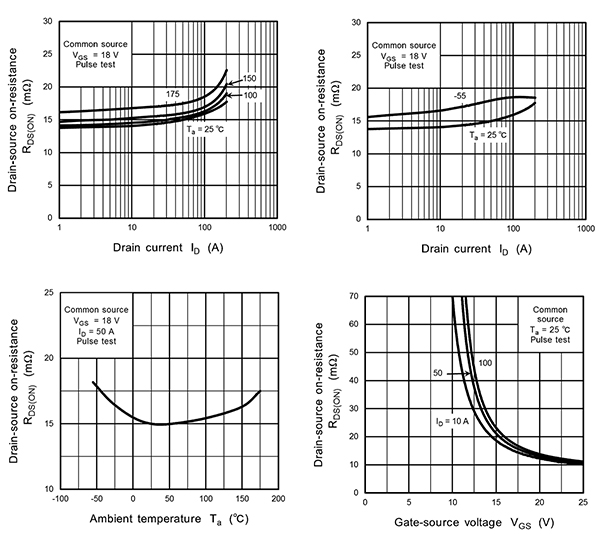 Figur 7: Her vises grafer som karakteriserer ON-motstand for TWO15N65C fra forskjellige perspektiver, deriblant drain-strøm, omgivelsestemperatur og VGS. (Bildekilde: Toshiba)
Figur 7: Her vises grafer som karakteriserer ON-motstand for TWO15N65C fra forskjellige perspektiver, deriblant drain-strøm, omgivelsestemperatur og VGS. (Bildekilde: Toshiba)
Det samme settet med spesifikasjoner og grafer er vist i figur 8 for 1200-volts enhetene, for eksempel TW140N120C, en N-kanal-enhet på 20 A og 107 watt. Denne SiC MOSFET-en har en lav CISS på 6000 pF, en gate-inngangsladning (Qg) på 158 nanocoulomb (nC) og en RDS(on) på 140 mΩ.
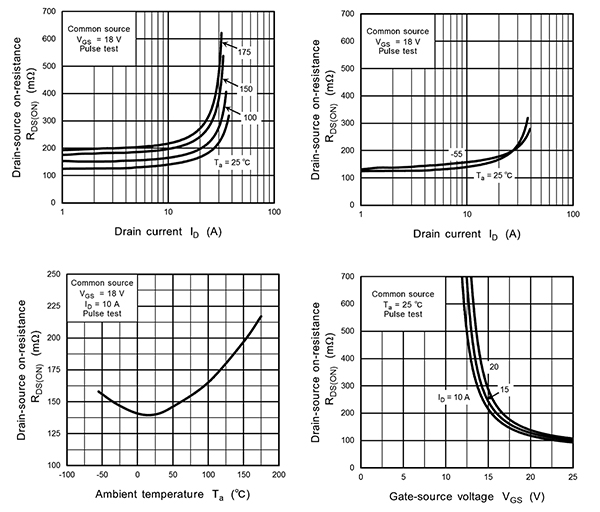 Figur 8: 140N120C sine karakteriseringsgrafer for ON-motstand. (Bildekilde: Toshiba)
Figur 8: 140N120C sine karakteriseringsgrafer for ON-motstand. (Bildekilde: Toshiba)
De ti tilgjengelige tredjegenerasjons Toshiba SiC MOSFET-ene består av fem 650-volts enheter samt fem 1200-volts enheter. Ved 25 °C har de følgende klassifikasjoner for ON-motstand, strøm og effekt:
650 volt:
- 15 mΩ, 100 A, 342 watt (TWO15N65C)
- 27 mΩ, 58 A, 156 watt
- 48 mΩ, 40 A, 132 watt
- 83 mΩ, 30 A, 111 watt
- 107 mΩ, 20 A, 70 watt
1200 volt:
- 15 mΩ, 100 A, 431 watt
- 30 mΩ, 60 A, 249 watt
- 45 mΩ, 40 A, 182 watt
- 60 mΩ, 36 A, 170 watt
- 140 mΩ, 20 A, 107 watt (TW140N120C)
Konklusjon
MOSFET-er av silisiumkarbid gir en betydelig forbedring i kritiske vekslingsparametere, sammenlignet med enheter som bare inneholder silisium. Sammenlignet med tidligere generasjoner, tilbyr tredjegenerasjons silisiumkarbidkomponenter forbedrede spesifikasjoner og kvalitetstall, økt pålitelighet, bedre karakterisering av krav til gate-driver og større innsikt i uunngåelige distinksjoner i konstruksjonen. Ved å bruke disse SiC MOSFET-ene har konstruktører av strømsystemer en ekstra kjerneressurs de kan bruke for å oppnå høyere effektivitet, mindre størrelse og forbedret generell ytelse.

Disclaimer: The opinions, beliefs, and viewpoints expressed by the various authors and/or forum participants on this website do not necessarily reflect the opinions, beliefs, and viewpoints of DigiKey or official policies of DigiKey.





