Slik kan tap reduseres, virkningsgraden forbedres og temperaturområdet utvides i konstruksjoner med høy effekt
Bidrag fra DigiKeys nordamerikanske redaktører
2023-09-08
Konstruktører av strømkrevende konstruksjoner krever mindre, lettere og mer effektive strømomformere, som er i stand til å fungere ved høyere spenninger og temperaturer. Dette gjelder spesielt i konstruksjoner som elbiler (EV – electric vehicle), der slike forbedringer betyr raskere lading og lengre rekkevidde. For å oppnå disse forbedringene bruker konstruktører effektomformere basert på WBG-teknologier (WBG – wide bandgap – bred båndavstand), for eksempel silisiumkarbid (SiC – silicon carbide).
Sammenlignet med silisium (Si – silicon), fungerer disse enhetene ved høyere spenninger og veier mindre, men de har likevel lignende strømstyringsmuligheter. De fungerer også ved høyere temperaturer, noe som reduserer kravene til kjølesystemet. SiC-enheter kan fungere ved høyere vekslingsfrekvens, noe som muliggjør bruk av mindre passive komponenter som reduserer omformerens størrelse og vekt. Likevel er SiC under konstant utvikling, og nyere arbeidsinnsats resulterer i lavere ON-motstand (på-motstand), noe som ytterligere reduserer effekttapet.
Denne artikkelen tar kort for seg fordelene med SiC sammenlignet med Si, og bruker elbiler som kontekst. Den tar deretter for seg SiC-utviklinger, og går så videre til å introdusere ROHM Semiconductor sine fjerdegenerasjons SiC MOSFET-er, og illustrerer hvordan disse hjelper konstruktører med å redusere strømtap, kostnader og fysisk størrelse
Derfor bør silisiumkarbid brukes
Elbiler trenger økt batterikapasitet for å gi bedre rekkevidde. I forbindelse med denne trenden, økes batterispenningene til 800 volt for å redusere ladetiden. Som et resultat trenger konstruktører av elbiler enheter som tåler disse høyere spenningene og samtidig reduserer elektriske tap og vekt. ROHM Semiconductor sine fjerdegenerasjons SiC MOSFET-er gir lavere tap takket være høyere spenningstoleranser, lavere konduksjons- og vekslingstap og mindre størrelser.
SiC, som er en WBG-halvleder, tilbyr eksepsjonell virkningsgrad i høyspente strømvekslingskonstruksjoner sammenlignet med Si MOSFET-teknologi. En sammenligning av de fysiske egenskapene til SiC og Si viser kilden til denne forbedringen basert på fem fysiske egenskaper: Nedbrytning av elektrisk felt, båndavstand, varmekonduksjonsevne og smeltepunkt (figur 1).
 Figur 1: Her vises fordelene til SiC sammenlignet med Si MOSFET-er, basert på fem fysiske egenskaper. (Bildekilde: ROHM Semiconductors)
Figur 1: Her vises fordelene til SiC sammenlignet med Si MOSFET-er, basert på fem fysiske egenskaper. (Bildekilde: ROHM Semiconductors)
Gjennombruddet for den elektriske feltstyrken til SiC er ti ganger større enn for Si, noe som gjør det mulig å konstruere enheter med høyere gjennombruddsspenninger, samtidig som tykkelsen til enheten reduseres. Den bredere båndavstanden til SiC gjør det mulig for enheten å fungere ved mye høyere temperaturer. Høyere varmeledningsevne reduserer arbeidsinnsatsen som trengs for å kjøle enheten, mens det høyere smeltepunktet øker driftstemperaturområdet. Til slutt resulterer den høyere mettede elektronvandringshastigheten til SiC i høyere mulige vekslingsfrekvenser og lavere vekslingstap. Disse høyere vekslingsfrekvensene krever mindre filtre og andre passive komponenter, noe som ytterligere reduserer størrelse og vekt.
MOSFET-utvikling
De opprinnelige SiC MOSFET-ene brukte en flat struktur der enhetens gate og kanal var på halvlederens overflate. Flate enheter er begrenset når det gjelder komponenttetthet, siden det er en grense for hvor mye konstruksjoner kan reduseres i størrelse for å forbedre enhetens kapasitet. Bruken av enkle og doble MOSFET-er gjør det mulig å oppnå høyere enhetstettheter (figur 2).
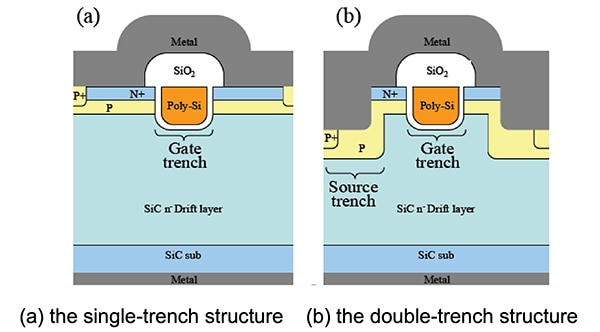 Figur 2: Trench-MOSFET-er oppnår høyere enhetstettheter ved å arrangere enhetselementene vertikalt. (Bildekilde: ROHM Semiconductor)
Figur 2: Trench-MOSFET-er oppnår høyere enhetstettheter ved å arrangere enhetselementene vertikalt. (Bildekilde: ROHM Semiconductor)
I likhet med andre MOSFET-er, inneholder en trench-MOSFET-celle drain, gate og source, men de er arrangert vertikalt. Kanalen dannes vertikalt, parallelt til gate-trenchen, ved hjelp av felteffekten. Retningen til strømflyten er vertikal fra source til drain. Sammenlignet med en flat enhet, som er spredt horisontalt og tar opp en god del av overflateområdet, er denne strukturen svært kompakt.
Den enkle trench-konstruksjonen bruker en trench med én gate. Enheten med to trencher har både en gate-trench og en source-trench. ROHM Semiconductor byttet til den doble trench-strukturen for sine tredjegenerasjons SiC MOSFET-er. Konstruksjonen til fjerdegenerasjonen forbedret den doble trench-konstruksjonen ved å redusere cellestørrelsen, noe som ytterligere reduserer ledemotstanden og parasittkapasitansen, noe som fører til mye lavere strømtap og gir muligheten til å bruke mindre SiC-enheter, og det gir mer kostnadseffektive systemkonstruksjoner.
Reduksjon av ledemotstanden til en MOSFET kan kompromittere dens evne til å håndtere kortslutninger. Den fjerdegenerasjons SiC MOSFET-en oppnår imidlertid lavere ledemotstand uten å ofre kortslutningsholdetiden, noe som gir disse enhetene en betydelig fordel når det gjelder å oppnå både høy virkningsgrad og kraftig kortslutningsrobusthet.
Slik kan vi forstå tap
Tapene i en omformer i vekslet modus kommer fra flere kilder, og de som er assosiert med de aktive enhetene inkluderer konduksjons-, vekslings- og body-diode-tap (figur 3).
 Figur 3: Her vises et skjema over en nedtransformerende (buck) DC-DC-omformer merket for å vise de vekslende bølgeformene og de tilknyttede tapsbølgeformene. (Bildekilde: ROHM Semiconductor)
Figur 3: Her vises et skjema over en nedtransformerende (buck) DC-DC-omformer merket for å vise de vekslende bølgeformene og de tilknyttede tapsbølgeformene. (Bildekilde: ROHM Semiconductor)
Nedtransformeringsomformeren bruker en totempolekonstruksjon med en MOSFET-veksler med høyside (SH) og lavside (SL. Vekslerne drives ut av fase slik at bare én vil lede om gangen. Gate-driver-bølgeformene (VGSH og VGSL) viser amplitudetrinnene på grunn av de tilknyttede ladeintervallene for enhetens parasittkapasitanser. Bølgeformene for drain-til-source-spenningen (VDSH, VDSL) og drain-strømmen (IDH, IDL) vises for begge enhetene. Når enheten er på, er VDS lav. Når enheten er av, er VDS høy. I løpet av tiden når SH er på, øker drain-strømmen lineært mens den lader magnetfeltet til induktoren. I løpet av denne tiden vil strømflyten som beveger seg gjennom kanalmotstanden utvikle en spenning over kanalen, noe som resulterer i konduksjonstap (PCOND) som er proporsjonale med kvadratverdien til strømmen og ON-motstanden til kanalen. Under intervallene hvor enheten endrer tilstand, er både spenningen og strømmen ulik null (non-zero), og strømmen avledes i enheten proporsjonalt med spenningen, strømmen, vekslingsovergangstiden og vekslingsfrekvensen. Dette er vekslingstapene.
En lignende situasjon oppstår når SL er på. Her avtar strømmen lineært ettersom energien som lagres i induktoren forsyner drain-strømmen i den nedre enheten. Her vil kanalmotstanden igjen avlede strøm som et konduksjonstap. Vær oppmerksom på at VDSL i den nedre enheten er nær null før strømmen blir ulik null, så det er ingen vekslingstap assosiert med denne delen av syklusen.
Gjenopprettingstapet (PQrr) forårsakes av gjenopprettingen av body-dioden til enhetene. For enkelhets skyld vises dette bare for høysiden.
Pbody er body-diodens konduksjon for enhetene. Dette tapet genereres av strømmen som ledes gjennom body-dioden til enheten på lavsiden.
Det totale effekttapet er summen av alle disse komponentene for begge transistorene.
Forbedret ytelse for fjerdegenerasjons SiC MOSFET-er
En sammenligning av ytelsen til Si IGBT og tredje- og fjerdegenerasjons SiC MOSFET-er ble utført ved å bruke en 5 kilowatt (kW) helbroinverter (figur 4). I denne helbrokretsen er vekslingsenhetene koblet parallelt for høyere strømkapasitet. Helbroen bruker totalt åtte enheter. De åtte enhetene vises montert på kjøleribben på venstre bilde. Virkningsgraden til kretsen ble evaluert ved å bruke den opprinnelige IGBT-en og de tredje- og fjerdegenerasjons MOSFET-ene. Inverteren fungerer ved en vekslingsfrekvens på 40 kilohertz (kHz) med SiC MOSFET-ene og ved 20 kHz med IGBT-en.
 Figur 4: Her vises en 5 kW vifteløs inverter og skjemaet for denne. Denne kretsen ble opprinnelig konstruert med silisium-IGBT-er som fungerer ved 20 kHz, og drives med både tredje- og fjerdegenerasjons SiC MOSFET-er på 40 kHz. Ytelsen til alle tre halvledertypene ble sammenlignet. (Bildekilde: ROHM Semiconductor)
Figur 4: Her vises en 5 kW vifteløs inverter og skjemaet for denne. Denne kretsen ble opprinnelig konstruert med silisium-IGBT-er som fungerer ved 20 kHz, og drives med både tredje- og fjerdegenerasjons SiC MOSFET-er på 40 kHz. Ytelsen til alle tre halvledertypene ble sammenlignet. (Bildekilde: ROHM Semiconductor)
Tredjegenerasjonsenheten var en ROHM Semiconductor SCT3030AL-enhet klassifisert til 650 volt, med en kanalmotstand (RDS(ON)) på 30 milliohm (mΩ). Den fjerdegenerasjons MOSFET-en var en ROHM Semiconductor SCT4026DEC11. Spenningsverdien til fjerdegenerasjonsenheten ble økt til 750 volt. Dens RDS(ON) er 26 mΩ, en 13 % reduksjon som reduserte konduksjonstapet noe.
En sammenligning av tapene til begge SiC MOSFET-ene med tapene til den opprinnelige IGBT-en, viser forbedringen i virkningsgrad (figur 5).
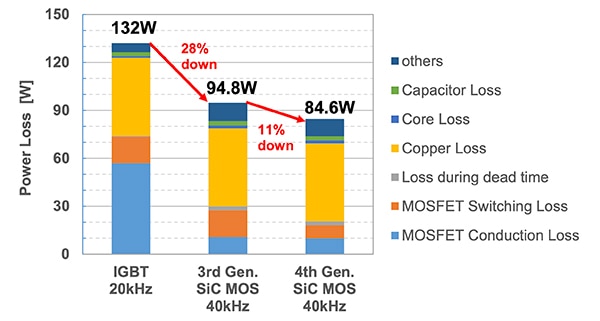 Figur 5: Fjerdegenerasjons SiC MOSFET-er reduserte tapene betydelig sammenlignet med den opprinnelige Si IGBT-en og tredjegenerasjonsenheten. (Bildekilde: ROHM Semiconductor)
Figur 5: Fjerdegenerasjons SiC MOSFET-er reduserte tapene betydelig sammenlignet med den opprinnelige Si IGBT-en og tredjegenerasjonsenheten. (Bildekilde: ROHM Semiconductor)
Fjerdegenerasjonsenheten reduserte konduksjonstapet (blå) fra 10,7 til 9,82 watt sammenlignet med tredjegenerasjonsenheten. En mer signifikant reduksjon, fra 16,6 til 8,22 watt, ble oppnådd med vekslingstap (oransje).
Ytterligere forbedringer i fjerdegenerasjonsenhetene inkluderer forbedret kapasitet for gate-driveren. De fjerdegenerasjons SiC MOSFET-ene støtter drift med 15 volt, og tredjegenerasjonsenhetene krever 18 volt. Dette betyr at kretser som er konstruert med Si-enheter kan bruke fjerdegenerasjons MOSFET-er som erstatninger med direkte utskiftning (drop-in). I tillegg er den anbefalte driftspenningen under avkobling 0 volt for fjerdegenerasjons SiC MOSFET-er. Før fjerdegenerasjonsproduktene var tilgjengelige, trengte gate-til-source-spenningen en negativ forspenning under avkobling for å forhindre selv-påkobling. I fjerdegenerasjonsenheter er imidlertid terskelspenningen (Vth) utviklet for å være høy for å kunne undertrykke selvpåkobling, noe som eliminerer behovet for å påføre negativ forspenning.
Fjerdegenerasjonsløsninger
ROHM Semiconductor sine fjerdegenerasjons SiC MOSFET-løsninger deles inn i to grupper basert på enhetens kapsling. SCT4026DEC11, som ble diskutert, er en 750-volts, 56 ampere (A) (+25 °C) / 29 A (+100 °C), 26 mΩ SiC MOSFET i en TO-247N-kapsling med tre ledere. Et eksempel på den alternative kapslingen med fire ledere er SCT4013DRC15, en 750-volts, 105 A (+25 °C) / 74 A (+100 °C), 13 mΩ-enhet i en TO-247-4L-kapsling med fire ledere.
Kapslingen med fire ledere legger til en ekstra leder som forbedrer vekslingshastigheten til MOSFET-en. Den konvensjonelle TO-247N-kapslingen med tre pinner isolerer ikke gate-driveren fra den parasittiske induktansen til source-lederen på grunn av høy drain-strøm. Gate-spenningen påføres mellom gate- og sourcepinnene. Den effektive gate-spenningen på brikken reduseres på grunn av spenningsfallet over den parasittiske induktansen (VL) til source-terminalen, noe som fører til at vekslingshastigheten reduseres (figur 6).
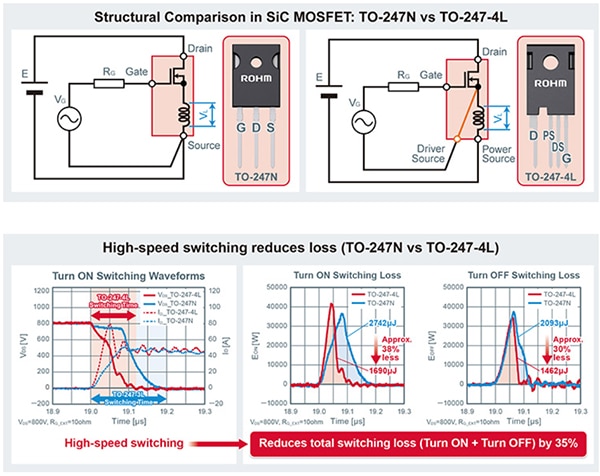 Figur 6: Den fjerde pinnen på TO-247-4L isolerer gate-driveren fra strømforsyningspinnene (power source pins) ved hjelp av en ekstra tilkoblingspinne i en Kelvin-tilkobling. (Bildekilde: ROHM Semiconductor)
Figur 6: Den fjerde pinnen på TO-247-4L isolerer gate-driveren fra strømforsyningspinnene (power source pins) ved hjelp av en ekstra tilkoblingspinne i en Kelvin-tilkobling. (Bildekilde: ROHM Semiconductor)
Den firepinners TO-247-4L-kapslingen deler gate-driveren og strømforsyningspinnene (power source pins) som internt kobler gate-driveren direkte til source. Dette minimerer virkningene av den parasittiske induktansen på source-pinnen. Den direkte tilkoblingen av gate-driveren til den interne source-tilkoblingen gjør det mulig å maksimere vekslingshastigheten til SiC MOSFET-er, noe som reduserer det totale vekslingstapet (slå PÅ og slå AV) med opptil 35 % sammenlignet med de konvensjonelle TO-247N-kapslingene med tre pinner.
Den andre differensierende spesifikasjonen for de fjerdegenerasjons SiC MOSFET-ene, er spenningsklassifiseringen. Enheter med spenningsklassifiseringer på 750 volt eller 1200 volt er tilgjengelige. De to enhetene vi har tatt for oss så langt, har spenningsklassifiseringer på 750 volt. For konstruksjoner med høyere spenninger har vi SCT4062KEC11, en 1200-volts, 62 mΩ, 26 A (+25 °C) / 18 A (+100 °C) SiC N-kanals MOSFET i en TO-247N-kapsling med tre ledere. SCT4036KRC15 er en 1200-volts, 36 mΩ, 43 A (+25 °C) / 30 A (+100 °C) N-kanals MOSFET i en TO-247-4L-kapsling med fire ledere. For tiden er det totalt ti fjerdegenerasjons SiC MOSFET-er tilgjengelige, og disse har strømklassifiseringer fra 26 A til 105 A ved +25 °C. De har RDS(ON)-verdier fra 13 til 62 mΩ.
Utrustninger for elbiler
Fjerdegenerasjons SiC MOSFET-spesifikasjoner er godt tilpasset elbilutrustninger. Batteri-elbiler (BEV – Battery EV) med spenninger på 400 eller 800 volt, gir et eksempel (figur 7).
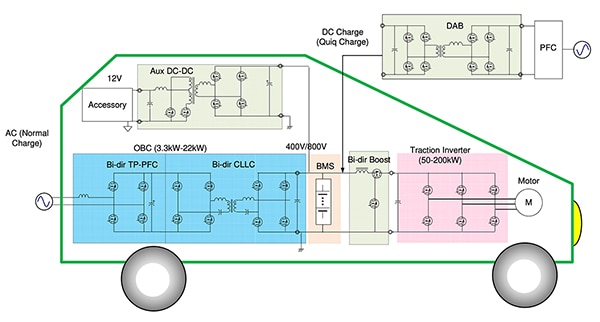 Figur 7: Vanlige fjerdegenerasjons SiC MOSFET-konstruksjoner i en batteri-elbil (BEV) og tilknyttet eksternt tilbehør. (Bildekilde: ROHM Semiconductor)
Figur 7: Vanlige fjerdegenerasjons SiC MOSFET-konstruksjoner i en batteri-elbil (BEV) og tilknyttet eksternt tilbehør. (Bildekilde: ROHM Semiconductor)
Figur 7 viser et blokkskjema over en batteri-elbil med en batterispenning på 400 eller 800 volt, som støtter både toveislading og rask lading. Den integrerte laderen (OBC – onboard charger) inkluderer kretser for totempol-effektfaktorkorreksjon (PFC – power factor correction) og en toveis, helbro CLLC (kondensator, induktor, induktor, kondensator) resonansomformer. Den eksterne «Quiq charge»-likestrømsladeren gir direkte lading til batteriet. Batteriet driver trekkraftinverteren, som konverterer likestrøm til trefaset vekselstrøm for å drive motoren. Alle disse kretsene bruker MOSFET-er i forskjellige kretskonfigurasjoner til å håndtere effektnivåene som kreves. Fjerdegenerasjons SiC MOSFET-er er viktige fordi de reduserer kretsens fysiske størrelse og øker spenningsklassifiseringen, samtidig som de reduserer tap og kostnader.
Konklusjon
For konstruktører av høyspente konstruksjoner med høy effekt, for eksempel elbiler, datasentre og basestasjoner, er fjerdegenerasjons SiC MOSFET-er viktige strømvekslingsenheter. Som vist bruker de en unik struktur til å forbedre strømomformingens virkningsgrad betydelig ved å redusere tap, samtidig som de reduserer den fysiske størrelsen og kostnadene.
Anbefalt lesing:

Disclaimer: The opinions, beliefs, and viewpoints expressed by the various authors and/or forum participants on this website do not necessarily reflect the opinions, beliefs, and viewpoints of DigiKey or official policies of DigiKey.







